发布时间:2024-04-15 | ![]() 浏览量:312
浏览量:312
萨瑞微电子2023年专利一介绍
一种半导体封装方法说明书
一、技术领域
本发明涉及半导体封装技术领域,具体涉及一种半导体封装方法。
二、背景技术
RGB显示模组包括三色芯粒与一基板,即蓝光、绿光与红光芯粒同时固定于基板之上,通电后可以控制其中的一个芯粒发光或者是控制任意几个芯粒同时发光,以发出各种颜色的光。
现有技术中,芯粒与基板通常采用键合工艺实现连接,在键合之前,需要在基板上朝向芯粒一侧的表面以及芯粒上朝向基板一侧的表面分别沉积键合介质,再将芯粒放置于基板之上,以在预设条件下执行键合工艺实现芯粒与基板的键合连接。
然而,单个RGB显示模组至少包括三个芯粒,采用如此键合工艺,则至少需要在三个芯粒以及基板上分别沉积键合介质,键合介质共计需要四次沉积,步骤繁琐,在RGB显示模组生产量大的情况下,该键合工艺将导致封装效率处于较低水平。
三、发明内容
针对现有技术的不足,本发明提供一种半导体封装方法,以解决此问题。封装方法可将蓝光芯粒、绿光芯粒、红光芯粒按照预设排布规则连接至基板上,以得到RGB显示模组。封装方法包括以下步骤:
1、获取基板的几何数据,根据基板的几何数据划定基板的封装区与非封装区。
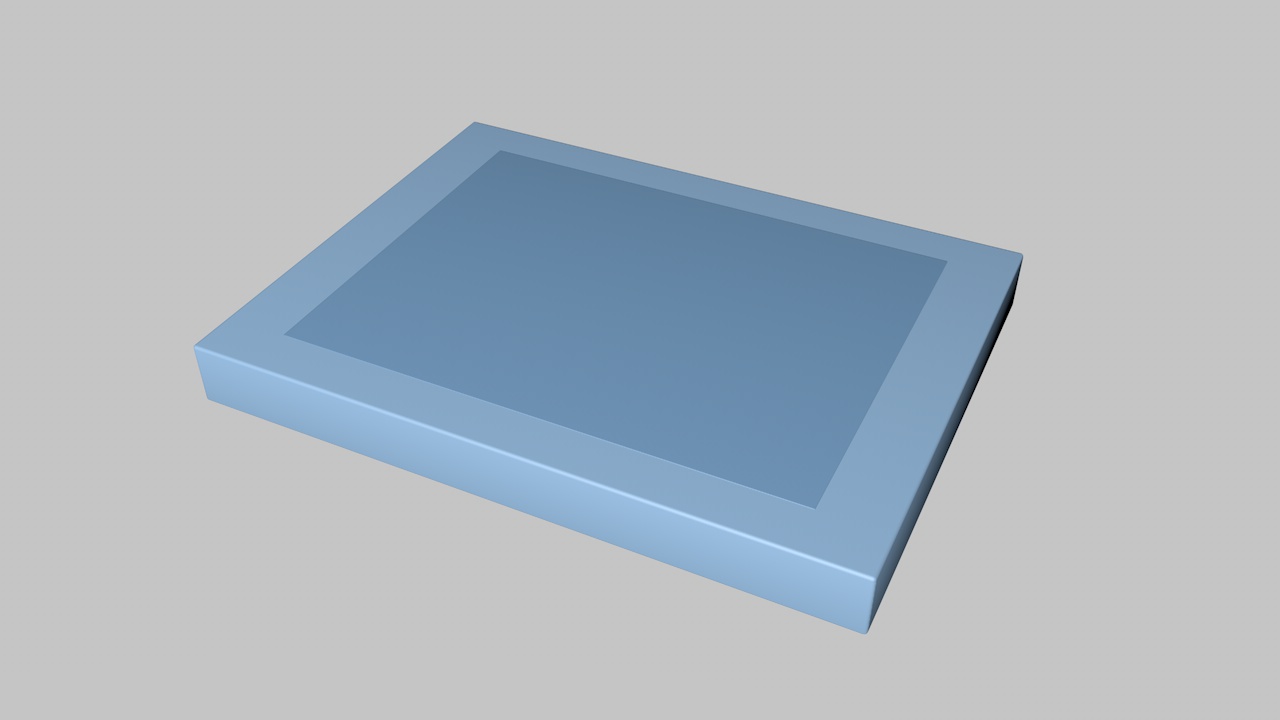
2、对基板进行离子注入以在封装区内形成截止层。其中,对基板进行离子注入包括N次离子注入,每次注入能量均相等,其中包括碳离子。此步骤具体细分为:
(1)将基板放置于离子注入机的机台之上,控制基板进行转动;
(2)在基板的转动过程中,对基板依次进行N次离子注入,直至基板内的离子浓度到达离子浓度预设值后,基于基板内注入的离子组分而形成截止层;
(3)在对基板进行离子注入时,首次注入的剂量为离子浓度预设值的一半,首次离子注入时基板的转动速度为第一转动速度,后每一次离子注入剂量均为前一次的一半,且除首次离子注入,剩余次数的转动速度均为第二转动速度。第二转动速度大于第一转动速度。
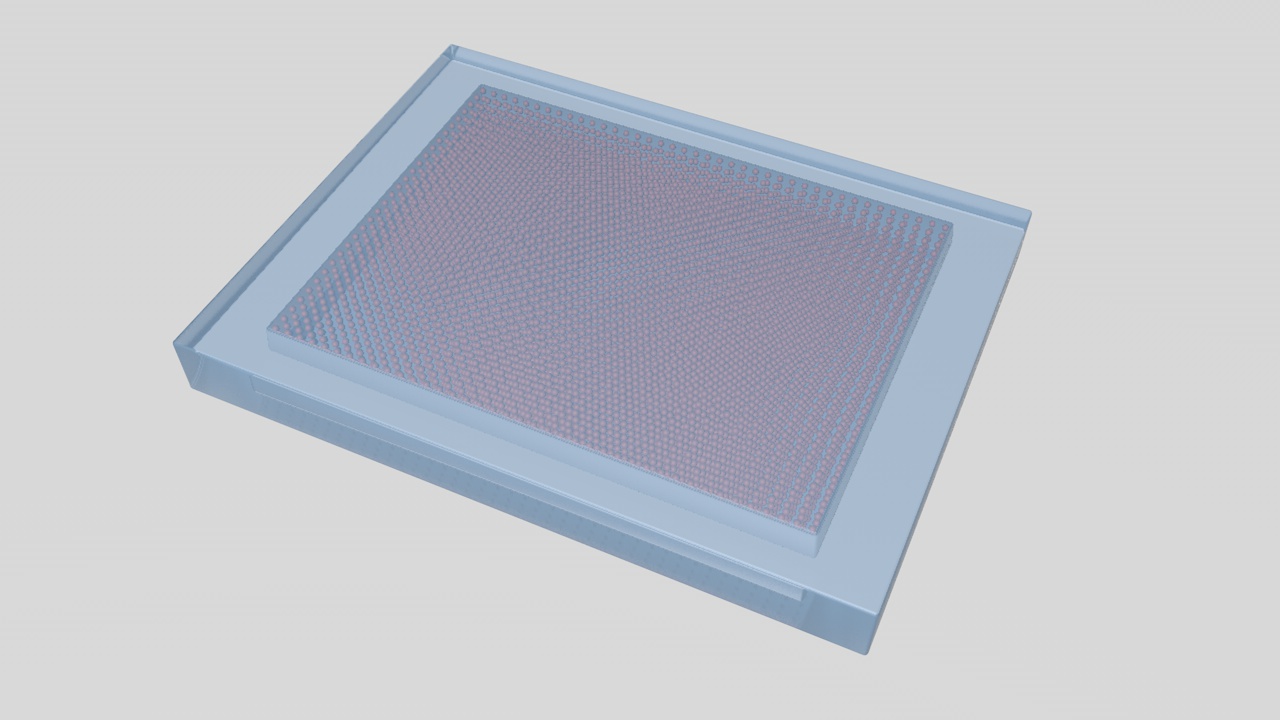
3、对基板的封装区的表面进行减薄处理至截止层,并在减薄处理的封装区的表面沉积双层的键合介质,包括沉积于封装区的表面之上的第一介质层以及沉积于第一介质层之上的第二介质层。此步骤具体细分为:
(1)根据基板的几何数据,在基板的第一表面覆盖能够暴露出封装区的表面的耐酸防护膜;
(2)采用化学机械研磨工艺对封装区的表面进行研磨减薄至露出截止层,并在研磨过程中喷洒含有SiO2颗粒的研磨液;
(3)对基板进行净化处理,并对基板进行干燥处理;
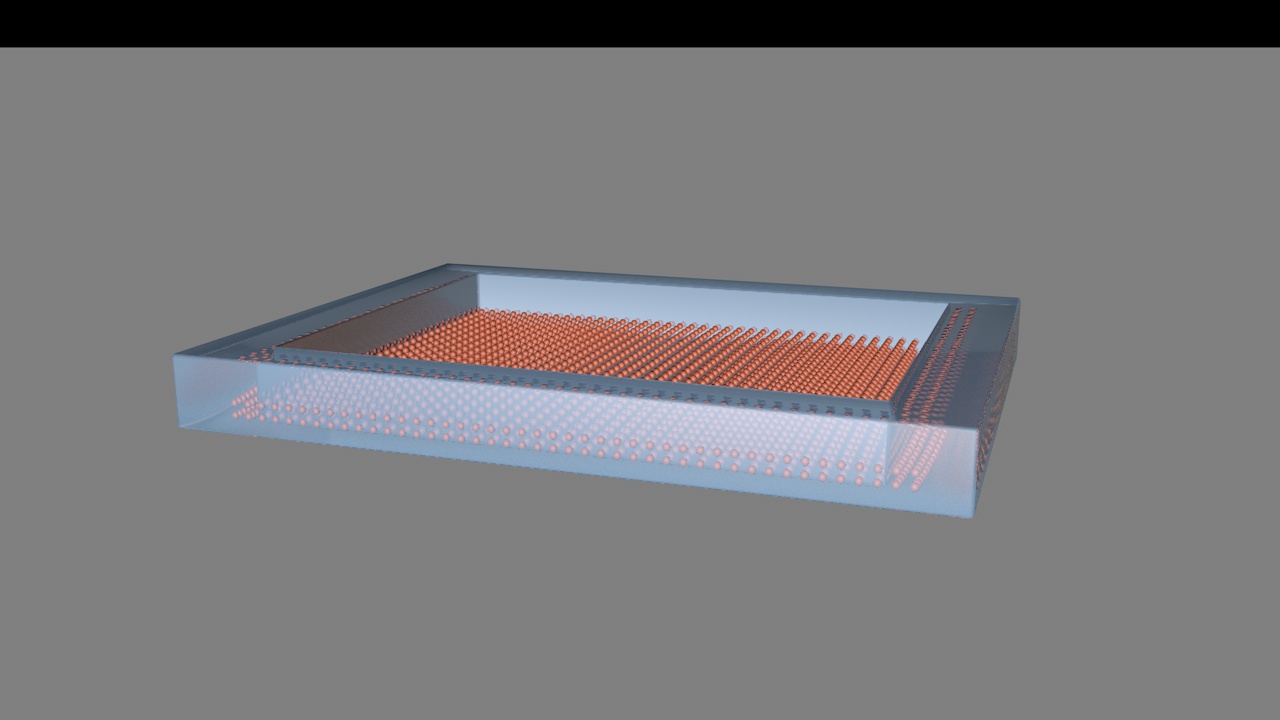
(4)采用物理气相沉积工艺在基板的第一表面依次沉积键合介质,其中,键合介质为Al2O3;
(5)将耐酸防护膜去除,以去除沉积于耐酸防护膜之上的键合介质。

4、将蓝光芯粒、绿光芯粒与红光芯粒按照预设排布规则布置于封装区之上,且与第二介质层接触。
5、在第一温度与第一压力的条件下,向蓝光芯粒、绿光芯粒与红光芯粒施加压力,以使蓝光芯粒、绿光芯粒与红光芯粒键合连接至第二介质层之上。
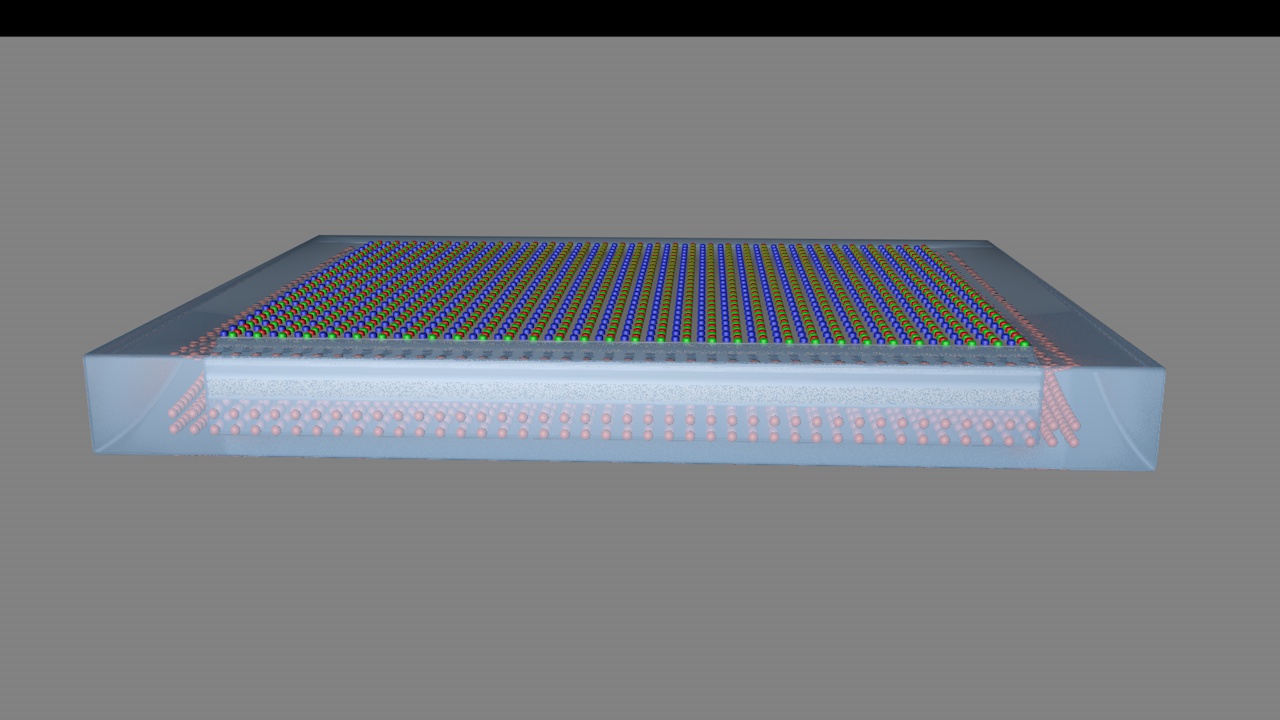
6、随后,增加温度,在第二温度与第二压力的条件下,向蓝光芯粒、绿光芯粒与红光芯粒施加压力,以使第二介质层键合到第一介质层之上。
7、随后,逐步降低温度,在第三温度与第二压力的条件下,向蓝光芯粒、绿光芯粒与红光芯粒施加压力以使第一介质层之上键合到基板封装区之上。
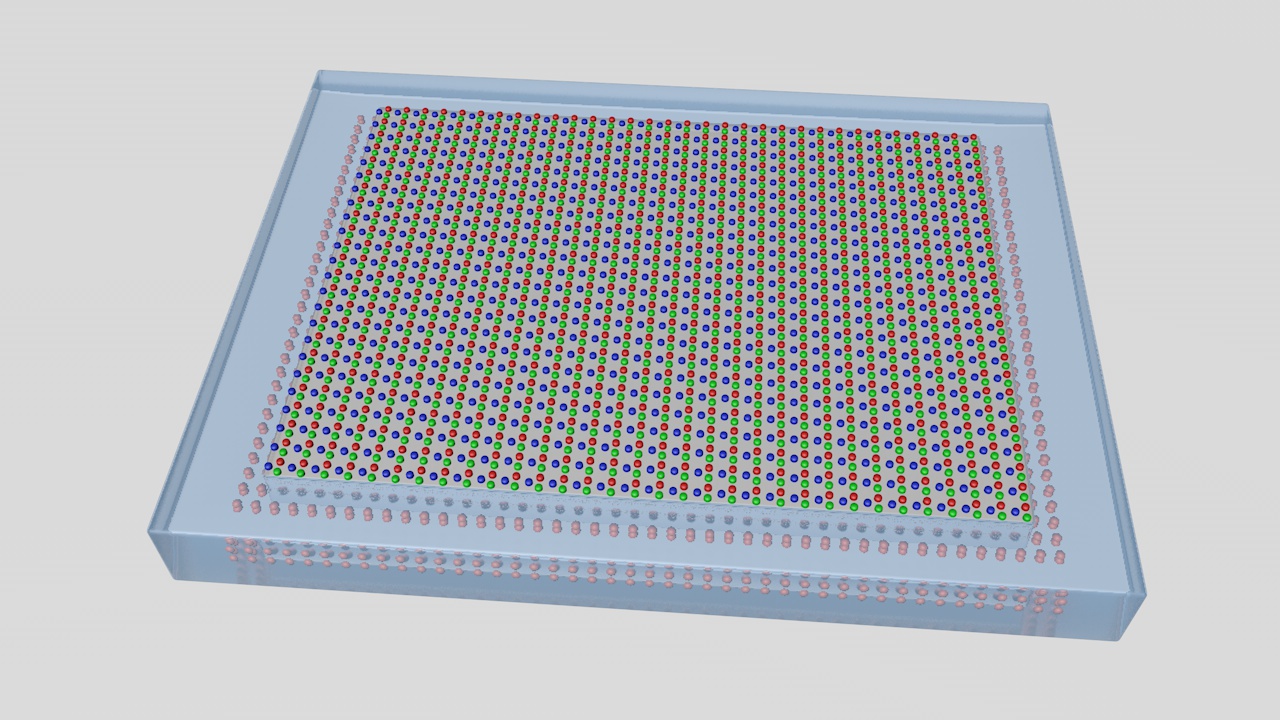
8、对键合后暴露于蓝光芯粒、绿光芯粒与红光芯粒以外的键合介质进行减薄处理使初始厚度减薄至目标厚度,以使键合介质的厚度等于封装区的深度,得到RGB显示模组。
说明:
1、第三温度<第一温度<第二温度,第一压力<第二压力。
2、第一温度为300℃—350℃、第二温度为600℃—700℃、第三温度为100℃—150℃;逐渐降低第二温度至第三温度的降温速率为90℃/min;
3、第一压力为10000kg,第二压力为15000kg。
四、有益效果
与现有技术相比,采用本发明的有益效果在于:稳固连接,过程简单,提升键合效率,键合介质与基板的非封装区处于同一水平面,表面更为美观。